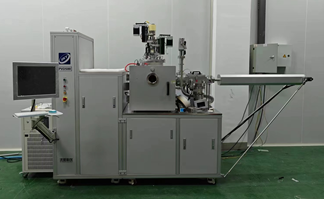
一、仪器简介
1、型号:PVD500
2、生产厂家:中国科学院沈阳科学仪器股份有限公司
3、主要技术指标:
一、应用范围和要求
系统为双室结构,主要由溅射真空室、进样室、磁控溅射靶、直流电源、射频电源、阳极层离子源、工作气路、旋转加热基片台、真空获得系统、安装机台、真空测量、水冷却及报警系统和控制系统等部分组成。主要用于Au、Ag、Pt、W、Mo、Ta、Ti、Al、Si、Cu、Fe、Ni、氧化铝、氧化钛、氧化锆、ITO、AZO、氮化钽、氮化钛等金属膜的制备。
二、溅射真空室性能指标
1、溅射真空室尺寸约500mm*500mm*500mm,304不锈钢材质,具备腔内烘烤功能、具备腔外照明功能,具有观察窗。
2、脂润滑分子泵及变频控制电源:1台,抽速≥1300L/s。
3、旋片真空泵:1台,抽速≥13L/s。
4、溅射真空室真空测量:数显真空计系统,1套,测量范围:1x105Pa-1x10-5Pa。
5、工艺真空测量:薄膜真空规系统,1套,规格≤13.3Pa。
6、溅射真空室极限真空度:≤7x10-5Pa
7、溅射真空室真空抽速:≤30min可达到6.6x10-4Pa
8、溅射真空室系统停泵关机12小时后,真空度≤5Pa。
9、磁控溅射系统要求:靶材≥3英寸,3套。每个靶需配备挡板;靶机距手动可调范围:110-150mm
10、直流溅射电源最大功率≥500W,2套;射频溅射电源最大功率≥500W,1套;
11、直流溅射电源要求输出功率范围为0W-500W,输出电流:0A-0.9A。射频电源频率为13.56MHZ。
12、溅射气体系统要求:200SCCM(氩气)、100SCCM(氮气)、100SCCM(氧气)质量流量控制器。(准确度:±1.5%F.S)
13、溅射系统:可单独溅射、轮流溅射及共溅射功能,磁控靶与基片的距离可调
14、基片加热炉炉温:500±1℃。
15、样品台:具有偏压电源。
16、系统控制:采用触摸屏集成自动控制方式。控制软件要有软件著作权。
#17、基片尺寸:最大可放置4英寸圆形样品;
#18、溅射膜厚均匀性优于±3%(以铜标定);共溅射φ100mm范围内(除去边缘效应)。
三、阳极层离子源
具备离子清洗功能,最大离子能量≥700eV。
四、进样室性能指标
1、进样室尺寸约:Ф300mm*250mm;手动取放样片采用1套电动磁力送样机构送样,采用304不锈钢,具有真空获得系统和真空测量系统。
2、进样室极限真空度:≤7X10-4Pa (经烘烤除气后);
3、进样室真空系统充干燥氮气破空,快速装入样品后开始抽气,≤30min可达到6.6x10-3Pa;
4、进样室停泵关机12小时后真空度:≤5Pa;
5、进样室真空脂润滑分子泵及变频控制电源:1台,抽速≥300L/s。
6、进样室真空测量系统:采用数显真空计,测量范围:1x105Pa-1x10-5Pa。
二、设备功能(测试项目)
1、主要用于Au、Ag、Pt、W、Mo、Ta、Ti、Al、Si、Cu、Fe、Ni、氧化铝、氧化钛、氧化锆、ITO、AZO、氮化钽、氮化钛等金属膜的制备。
2、多靶材倾斜共溅射的方式,可沉积混合物/化合物薄膜。
3、在溅射过程中加入氧、氮或其它活性气体,可沉积形成靶材物质与气体分子的化合物薄膜。
三、样品要求
1、样品尺寸要求:样品尺寸最小需大于1*1cm,仪器可镀的最大尺寸为6英寸。
2、样品非粉末,不掉粉,不掉渣,高温镀膜的样品需要耐高温。
四、收费标准
1、校内送样测试:1000元/h;
2、校外送样测试: 2000元/h。
五、联系方式
1、联系人:张倩倩,0531-88364068,qianqianzhang@sdu.edu.cn
2、设备放置地点:晶谷产业园(山东大学晶体材料中试基地)19号楼二楼
